您可以填写下面的资料留言给我们,我们会尽快回复您。
*为必填项

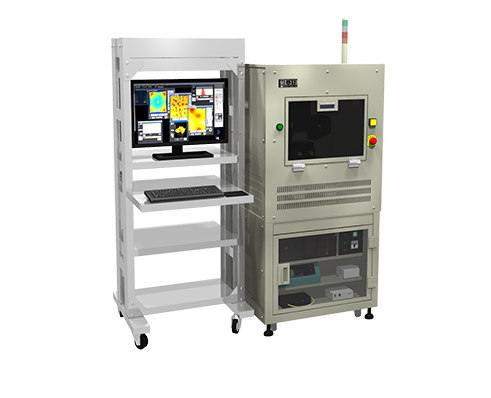


常规椭偏仪是单点测试,因此要取得整面膜厚均匀性数据是需要N个小时的工作,而且小的测量分辨率就是激光光斑大小,
无法取得微小区域的膜厚分布数据。
ME-210是采用独自开发的微小偏光阵列片(光子晶体)来克服上述两大问题的设备。
能以快速取得大12inch基板上的膜厚分布
能以高分辨率取得微小区域的膜厚分布(设备高分辨率为5.5um*5.5um)
设备软件具有模拟功能,因此能比对模拟值与实际值来评估成膜工艺
透明基板的膜厚测量
| 重复精度 | 薄膜厚度:0.1nm 折射率:0.001 *Si 上的 SiO2 膜(厚度约 100nm)的一点重复测量 100 次时的标准偏差值 |
| 测量速度 | 900 点/分钟以上(广域模式 100mm 方形区域测量) 5000 点/分钟或以上(高清模式 1mm 方形区域测量) |
| 光源 | 半导体激光器(波长 636nm) |
| 测量点 | 广域模式:0.5mm 高清模式:5.5μm |
| 入射角度 | 70 度 |

固话:010-69798893
鲁工:13910937780(微信同号)
王工:17600738803(微信同号)
传真:010-69798893 邮箱:sales@oelectron.com
地址:北京市昌平区回龙观龙冠大厦614室

北京欧屹科技有限公司 版权所有 © 2024 All Rights Reserved. 京ICP备15048507号-1 技术支持:助标网络
